在SMT回流焊工艺造成对元件加热不均匀的原因主要有:回流焊元件热容量或吸收热量的差别,传送带或加热器边缘影响,回流焊产品负载等三个方面。
通常PLCC、QFP与一个分立片状元件相比热容量要大,焊接大面积元件就比小元件更困难些。
在回流焊炉中传送带在周而复使传送产品进行回流焊的同时,也成为一个散热系统,此外在加热部分的边缘与中心散热条件不同,边缘一般温度偏低,炉内除各温区温度要求不同外,同一载面的温度也差异。
产品装载量不同的影响。回流焊的温度曲线的调整要考虑在空载,负载及不同负载因子情况下能得到良好的重复性。负载因子定义为:LF=L/(L S);其中L=组装基板的长度,S=组装基板的间隔。
回流焊工艺要得到重复性好的结果,负载因子愈大愈困难。通常回流焊炉的负载因子的范围为~。这要根据产品情况(元件焊接密度、不同基板)和再流炉的不同型号来决定。要得到良好的焊接效果和重复性,实践经验很重要。
在波峰焊接阶段,PCB必须要浸入波峰中将焊料涂敷在焊点上,因此波峰的高度控制就是一个很重要的参数。可以在波峰上附加一个闭环控制使波峰的高度保持不变,将一个感应器安装在波峰上面的传送链导轨上。
随着元器件变得越来越小而PCB越来越密,在焊点之间发生桥连和短路的可能性也因此有所增加。
但已有了一些行之有效的方法可用来解决这种问题,其中一种方法是采用风刀技术。这是在PCB离开波峰时用一个风刀向熔化的焊点吹出一束热空气或氮气,这种和PCB一样宽的风刀可以在整个PCB宽度上进行质量检查,消除桥连或短路并减少运行成本。
工艺发展趋势
随着众多电子产品向小型、轻型、高密度方向发展,特别是手持设备的大量使用,在元器件材料工艺方面都对原有SMT技术提出了严峻的挑战,也因此使SM得到了飞速发展的机会。
lC引脚脚距发展到mm、、,BGA已被广泛采用,CSP也崭露头角,并呈现出快速上涨趋势,材料上免清洗、低残留锡膏得到广泛应用。所有这些都给回流焊工艺提出了新的要求,一个总的趋势就是要求回流焊采用更的热传递方式,达到节约能源,均匀温度,适合双面板PCB和新型器件封装方式的焊接要求,并逐步实现对波峰焊的全面代替。
总体来讲,回流焊炉正朝着、多功能和智能化方向发展,主要有以下发展途径,在这些发展领域回流焊了未来电子产品的发展方向。
许多用户使用自动化在线式设备一周七天地进行制造和组装。因此,生产率的问题比以前更为重要,所有设备都必须要有尽可能高的正常运行时间。在选择波峰焊设备时,必须要考虑各个系统的MTBF(平均时间)及其MTTR(平均修理时间)。如果一个系统采用了可以抬起的面板、可折起的后门以及操纵台式检修门而具有较高的易维护性,就可达到较低的MTTR。类似地,考虑一下减少焊锡模块的维护和减少助焊剂涂敷装置的维护也可以取得较短的维护时间。
转塔型元件送料器放于一个单坐标移动的料车上,基板(PCB)放于一个X/Y坐标系统移动的工作台上,贴片头安装在一个转塔上,工作时,料车将元件送料器移动到取料位置,贴片头上的真空吸料嘴在取料位置取元件,经转塔转动到贴片位置(与取料位置成180度),在转动过程中经过对元件位置与方向的调整,将元件贴放于基板上。
对元件位置与方向的调整方法:
相机识别、X/Y坐标系统调整位置、吸嘴自旋转调整方向,相机固定,贴片头飞行划过相机上空,进行成像识别。
一般,转塔上安装有十几到二十几个贴片头,每个贴片头上安装2~4个真空吸嘴(较早机型)至5~6个真空吸嘴(现有机型)。由于转塔的特点,将动作细微化,选换吸嘴、送料器移动到位、取元件、元件识别、角度调整、工作台移动(包含位置调整)、贴放元件等动作都可以在同一时间周期内完成,所以实现真正意义上的高速度。快的时间周期达到~秒钟一片元件。
此机型在速度上是优越的,适于大批量生产,但其只能用带状包装的元件,如果是密脚、大型的集成电路(IC),只有托盘包装,则无法完成,因此还有赖于其它机型来共同合作。这种设备结构复杂,造价昂贵,机型约在US$50万,是拱架型的三倍以上。
构成当前贴片机品种许多,但无论是全自动高速贴片机或是手动低速贴片机,它的全体布局均有类似之处。




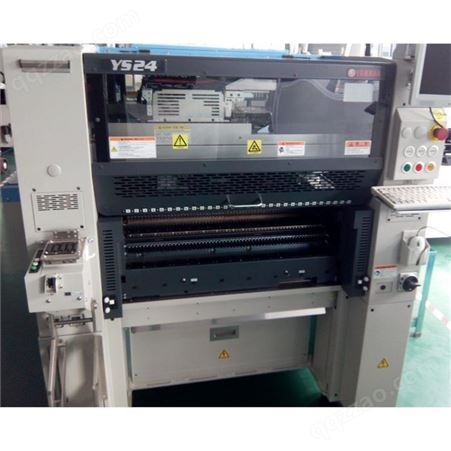












所有评论仅代表网友意见,与本站立场无关。